Product List\ Catalysts\ Ligands\ CVD/ALD Precursors\ Bubblers & Other Equipment\ Acronyms\ Kits\ Product Families\ Product Blog CAS Number Product Catalog CCTBA as MOCVDprecursor MOCVD A cu /A tot > 65% CMP ULK ULK Barrier (TaN) Liner (Co) EDX/TEM Conformal deposition in small structures (28 nm node ) MWislicenus et al MAM 18 Cobalt wheel 13 Lukas Gerlich CMC Conference 18 – Phoenix, AZ Cobalt Liner Capping CoCMP consum ables CoN Barrier Direct on CoCctbbbreviation/shorthand CCTBA in the Academic & Science field in general and in the Chemistry terminology in particular Dicobalt Hexacarbonyl TertButylacetylene Academic & Science » ChemistryCCTBA Formula H C 12 10 Co 2 O 6 Molecular weight CASNo 69 9 Ingredient Name % CAS Number Dicobalt
Novel Endogenous Insulin Stimulated Akt2 Protein Interaction Partners In L6 Myoblasts
Cctba precursor
Cctba precursor- A recent observation is that some of the Co 0 precursors such as CCTBA (Co003) undergo exothertic decomposition at temperature below 0 ° C while others undergo endothermic decomposition 105 Deposition on oxides appears to be profoundly different than deposition on metallic substrates, presumably due to differences between the surface electron density of nonMOCVD Co films as Cu seed replacement are deposited using CCTBA precursor Impact of different film properties on cobalt resistivity is evaluated and modeled Resistivity increase at low film thicknesses is mainly caused by surface roughness



2
Ru precursors families options Physical state Volatility Stability Ru3(CO)12 Ru(EtCp)2 Ru(TMCH)2 Amidinate βdiketonates RuO4 0,001 0,01 0,1 1 10 100 1000 70 1 170 2 V a p o r p r e s s u r e (T o r r) Temperature CYPRUS TORUS Ru(EtCp)2 RuCp2 Ru3(CO)12 Ru(dmp)3 Vapor pressure of selected Ru precursors Ru(TMCH)2 RuO4 o Ru ALD/CVD is The performance of a bubbler to deliver the lowvolatility, liquid cobalt precursor μ2 η2(tBu acetylene) dicobalthexacarbonyl (CCTBA) for reducedpressure chemical vapor deposition and atomic layer deposition processes was characterizedThe performance of a bubbler to deliver the lowvolatility, liquid cobalt precursor μ²η²(tBuacetylene) dicobalthexacarbonyl (CCTBA) for reducedpressure chemical vapor
Afterwards, the Co thin film was fabricated at a temperature of 150 °C using the Hexacarbonyl (3,3dimethyl1butyne) dicobalt (CCTBA) precursor at 5 Torr by MOCVD Subsequently, the ECD process was accomplished on the coupon level in a labAnd contacting the precursor vapor with a substrate under vapor deposition conditions effective for depositing on the substrate (i) high purity, low resistivity cobalt or (ii) cobalt that is annealable by thermal annealing to form high purity, low The reaction of the cobalt precursor molecule with the growing film surface was investigated by in situ quartz crystal microbalance (QCM), and the QCM result also indicates that CpCo(CO) 2 thermally decomposes to cobalt on the growth surface at 0 °C
Moreover, oxygen and carbon are part of the precursor usedCCTBA, and their existence is inevitable, as also pointed out by Lee etal 95 Later on, any form of Co oxide, in addition to any However, no improvement in film properties relative to (tertbutylacetylene)dicobalt hexacarbonyl (CCTBA) was demonstrated Also, (tertbutyl methyl acetylene) dicobalt hexacarbonyl is a high melting (ca 160° C) solid Precursors which are liquid at the precursor delivery temperature, or, more preferably, room temperature, are more desirableA cobalt deposition process, including volatilizing a cobalt precursor selected from among CCTBA, CCTMSA, and CCBTMSA, to form a precursor vapor;



2



2
The data shown represent the deposition of Cobalt using a (3,3Dimethyl1butyne) dicobalthexacarbonyl (CCTBA) precursor This chemical system is merely exemplary, and in other embodiments other metal organic or halogen species may be used to deposit cobalt, or other metalCobalt Precursor Abbreviation R' R synthesized mp bp STA T 50 STA % NVR Film Growth NMR Conducting Films Deposition Rate CCTBA H tButyl yes 13 1384 68 yes yes yes 1 CCTMSA H TMSi yes 31 13 58 yes yes yes 095 CCBTMSA TMSi TMSi yes 81 1756 18 yes yes yesUmicore PMC CMC Conference May 17 13 Challenges in Cobalt Sourcing Health & Safety even as Social and Environmental Challenges Challenges inherently linked to Cobalt mining




Atomic Layer Deposition Of P Type Semiconducting Thin Films A Review Tripathi 17 Advanced Materials Interfaces Wiley Online Library



2
Abstract A new family of highly volatile alkylsilylfunctionality Co precursors, R 3 SiCo(CO) 4, has been synthesizedOne of them, Et 3 SiCo(CO) 4, has been evaluated by low temperature thermal chemical vapor deposition (CVD) and atomic layer deposition (ALD), which gave low resistive (29 μΩ·cm) pure Co films with a good step overageDynamic stability test of EtPrecursors and Gases in the Plasma Enhanced Atomic Layer Deposition Publication Database A wide variety of chemical precursors have been investigated for applicability to plasma enhanced atomic layer deposition Some precursors have proven themselves to be extremely useful while others have failed to yield useful processes(3,3Dimethyl1butyne)dicobalt hexacarbonyl has been used as a precursor of Co films deposited by plasmaenhanced atomic layer deposition (PEALD) for Cu direct plating The electrical properties of PEALD Co films of sub nm thickness were determined by assessing continuities, morphologies, and impurities



2



2
Developing electronic precursor chemicals does not need to be a challenge At Umicore, we specialise in developing chemicals that can be applied to new electronic industries With expertise in high purity chemical synthesis, we are a onestop collaborative partner to help overcome the challenges commonly faced in the electronics industry There is very few precursors are available as a Co source and we chose CCTBA (dicobalt hexacarbonyl tertbutylacetylene) as Co source and hydrogen as a reactant gas Reaction mechanism in both ALD and CVD was studied in the deposition system equipped with quadrupole mass spectrometer(QMS) and Auger electron spectroscope (AES)We deliver advanced chemistry and process technology in precursor materials for the semiconductor industry and LED lighting applications From laboratory scale molecular design in R&D to high volume scale up, our rich portfolio of high purity metal and dielectric precursor materials empower FEOL (= Front end of line) and BEOL (= Back end of line) applications



2




Cobalt Cas Number 69 9 Strem Product Catalog
CCTBA is an example of a terminal alkyne, tertbutylacetylene bridging a dicobalthexacarbonyl core In an embodiment where the metal precursor is Co 2 (CO) 6 (R 1 C≡CR 2), R 1 and R 2 are individually selected from a straight or branched hydrocarbon group having one to six carbon atoms which may be interrupted and/or substituted Monovalent "Temperature is the number one thingPrecursor delivery methodology under a wide set of temperature, pressure, flow conditions and for a wide array of precursor chemistry The IR test system was extensively studied for several solid precursors, including Cp₂Mg, W(CO)₆, PDMAT, and TMI Liquids such as CCTBA and gases, such as WF₆ and B₂H₆ have been examined with equal1 (canceled) 21 A precursor or precursor composition for a vapor deposition process of a cobalt film, the precursor or precursor composition comprising a bridging asymmetric haloalkynyl dicobalt hexacarbonyl precursor of formula Co2(CO)6(R3CidentCR4), wherein R3 and R4 are different organic moieties and R4 is an electron withdrawing organic moiety relative to R3



Koreascience Or Kr




Woa1 Cobalt Cvd Google Patents
Carbonyl tertbutylacetylene, CCTBA, molecular weight of g/mol) as a Co precursor because of its high vapor pressure and volatility, a liquid state and its excellent thermal stability under normal conditions Kang et al characterized the physical and electrical properties of Co films deposited by MOCVD using CCTBA precursor, andThe publication database currently has 1609 entries Search from 2 Films Compositions 272 Precursors and Plasma Gases 76 Deposition Hardwares 249 Film and Plasma Characteristics 85 Theses Use Multifactor Search for more complex searches and for searching by other criteria (author, affiliation, analysis, deposition temperature)And contacting the precursor vapor with a substrate under vapor deposition conditions effective for depositing on the substrate (i) high purity, low resistivity cobalt or (ii) cobalt that is annealable by thermal annealing to form high purity, low




コンプリート Cctba Mtbe Decomposition



2
CCTBA is an example of a terminal alkyne, tertbutylacetylene bridging a dicobalthexacarbonyl core In an embodiment where the metal precursor is Co 2 (CO) 6 (R 1 C≡CR 2), R 1 and R 2 are individually selected from a straight or branched hydrocarbon group having one to six carbon atoms which may be interrupted and/or substituted MonovalentChain for high volume Cobalt precursors CMC Conference May 17 Dr Oliver Briel 2 CCTBA DCOC? A CCTBA minimum detectable molecular density as low as ≈3 × 10 13 cm −3 was calculated (with no signal averaging and for a sampling rate of 0 Hz) While this NDIR gas analyzer was specifically tested for CCTBA, it is suitable for characterizing the vapor delivery of a range of carbonylcontaining precursors



2



2
In this study, we used dicobalt hexacarbonyl tertbutylacetylene (C 12 H 10 O 6 Co 2, CCTBA) as a Co precursor because of its high vapor pressure, liquid state, and excellent thermal stability under normal conditionsThe conditions for deposition of CCTBA were precursor delivery temperature=35° C, wafer temperature=175° C, deposition time=3 minutes Cobalt film deposited from CCTBA at 150° C contained lower amount of carbon, 62 at %, but the amount of carbon in the film was still significantly higher compared to amount of carbon in cobalt filmHexacarbonyltbutylacetylene (CCTBA) precursor19 15–30A Ta was PVD deposited by a sputtering process B/L/S film stacks were prepared on a 300 mm wafer PVD/CVD cluster tool without breaking vacuum Two types of Cu seed processes were evaluated a conventional resputtered Cu seed and a reflow Cu seed Cu resputtering is




Cobalt Cas Number 69 9 Strem Product Catalog



2
The performance of a bubbler to deliver the lowvolatility, liquid cobalt precursor μ 2η 2(t Buacetylene) dicobalthexacarbonyl (CCTBA) for reducedpressure chemical vapor deposition and atomic layer deposition processes was characterized A relatively large process window was investigated by varying carrier gas flow rate, system pressure, and bubblerThe Applied Endura® Volta® CVD Cobalt system sustains Applied's technical leadership in CVD, introducing the first material change in more than 15 years of copper barrier/seed (CuBS) development to enable continued highperformance interconnect scaling The firstofitskind technology makes possible deposition of seedenhancing liner and selective cap layers less thanNew precursors and chemistry for the growth of transition metal films by atomic layer deposition by thomas joseph knisley dissertation submitted to the graduate school



Pubs Acs Org



2
A CCTBA minimum detectable molecular density as low as ≈3 × 1013 cm3 was calculated (with no signal averaging and for a sampling rate of 0 Hz) While this NDIR gas analyzer was specifically tested for CCTBA, it is suitable for characterizing the vapor delivery of a range of carbonylcontaining precursorsSTREM# ALD precursor Deposition of cobalt thin films on ALD WN as a glue layer for copper interconnects in microand nanoelectronics High thermal stability at deposition temperature (350°C) Low TGA residual mass 9% Highly air and moisture sensitive Inorg Chem, 03, 24, Strem Chemicals 24 Bis(N,N'diipropylacetamidinato)cobalt(II), min 98% Co(iPrWe deliver advanced chemistry and process technology in precursor materials for the semiconductor industry and LED lighting applications From laboratory scale molecular design in R&D to high volume scale up, our rich portfolio of high purity metal and dielectric precursor materials empower FEOL (= Front end of line) and BEOL (= Back end of line) applications



원소 구분 아이켐스 Ald Precursor 전구체와 유기금속화합물 제조



2
2 cobalt precursor was used together with O3 to deposit cobalt oxide films The optimal deposition temperature for this process was 1 ºC, at which polycrystalline and phasepure Co3O4 thin films were obtained The formation of mixed valence Co3O4 films from a Co(II) precursor occurred due to the high oxidative power of O3 The Co3O4 A CCTBA minimum detectable molecular density as low as 3 x 1013 cm 3 was calculated with no signal averaging and for a sampling rate of 0 Hz While this NDIR gas analyzer was specifically tested for CCTBA, it is suitable for characterizing the vapor delivery of a wide range of carbonylcontaining precursorsHP CCTBA* High Purity dicolbalt hexacarbonyl tertbutylacetylene TDMAT Tetrakisdimethylamino Titanium TiCl4 Titanium tetrachloride WCl6 Tungsten hexachloride WCl5 Tungsten pentachloride Joppa27™ (In collaboration with AMAT) Precursors for cobalt (selective or nonselective)* TBTEMT (Tertbutylimido)tris(ethylmethylamido)tantalum(V)



2



2
About (3,3Dimethyl1butyne)dicobalt Hexacarbonyl (3,3Dimethyl1butyne)dicobalt Hexacarbonyl (CCTBA, Dicobalt hexacarbonyl tertbutylacetylene) is one of numerous organometallic compounds manufactured by American Elements under the trade name AE Organometallics™ Organometallics are useful reagents, catalysts, and precursor materials withDifficult to vaporize precursors Liquids that have a narrow thermal window between vaporization temperature and thermal decomposition (TEMAZr, CCTBA) and/or have low vapor pressure can be problematic to vaporize The Performance Enhanced TurboVaporizerTM utilizes a novelCobalt films were deposited by metal organic chemical vapor deposition (MOCVD) using C 12 H 10 O 6 (Co) 2 (dicobalt hexacarbonyl tertbutylacetylene, CCTBA) as the Co precursor and H 2 reactant gas The impurity content of the Co films was monitored as a function of the partial pressure of H 2 > reactant gas




Underline In Vacuo Fabrication Of Thin Film Cobalt Monosilicide Cosi On 300 Mm Wafer Level




Nanmat Technology Co Ltd Cvd Ald Chemical Vapr Deposition Atomic Layr Depostion
Nanmat has been established in the Kaohsiung Nanzi Processing Zone since 1998 (currently renamed Kaohsiung Nanzi Technology Industrial Park), and is a local company dedicated to the development of semiconductor CVD/ALD (Chemical Vapor Deposition /Atomic Layer Deposition) in Taiwan Professional research and manufacturing of various advancedA cobalt deposition process, including volatilizing a cobalt precursor selected from among CCTBA, CCTMSA, and CCBTMSA, to form a precursor vapor;Both inconsistencies in precursor naming and a lack of universally with welldefined composition and characteristics to be included in accepted chemical acronyms For the most part, the compound name the reduced geometries and features of future devices, led by the IC (CCTBA) Co 2 (CO) 6 (η



Deposition Materials



2




Calculation Of The Reaction Rate Limited Saturation Time As A Function Download Scientific Diagram




Experiment Based Modelling Of A Vapor Draw Ampoule Used For Low Volatility Precursors Abstract Europe Pmc



2




Deposition Chemical Selection Guide Entegris Deposition Chemical Selection Guide Deposition Precursors Pdf Document
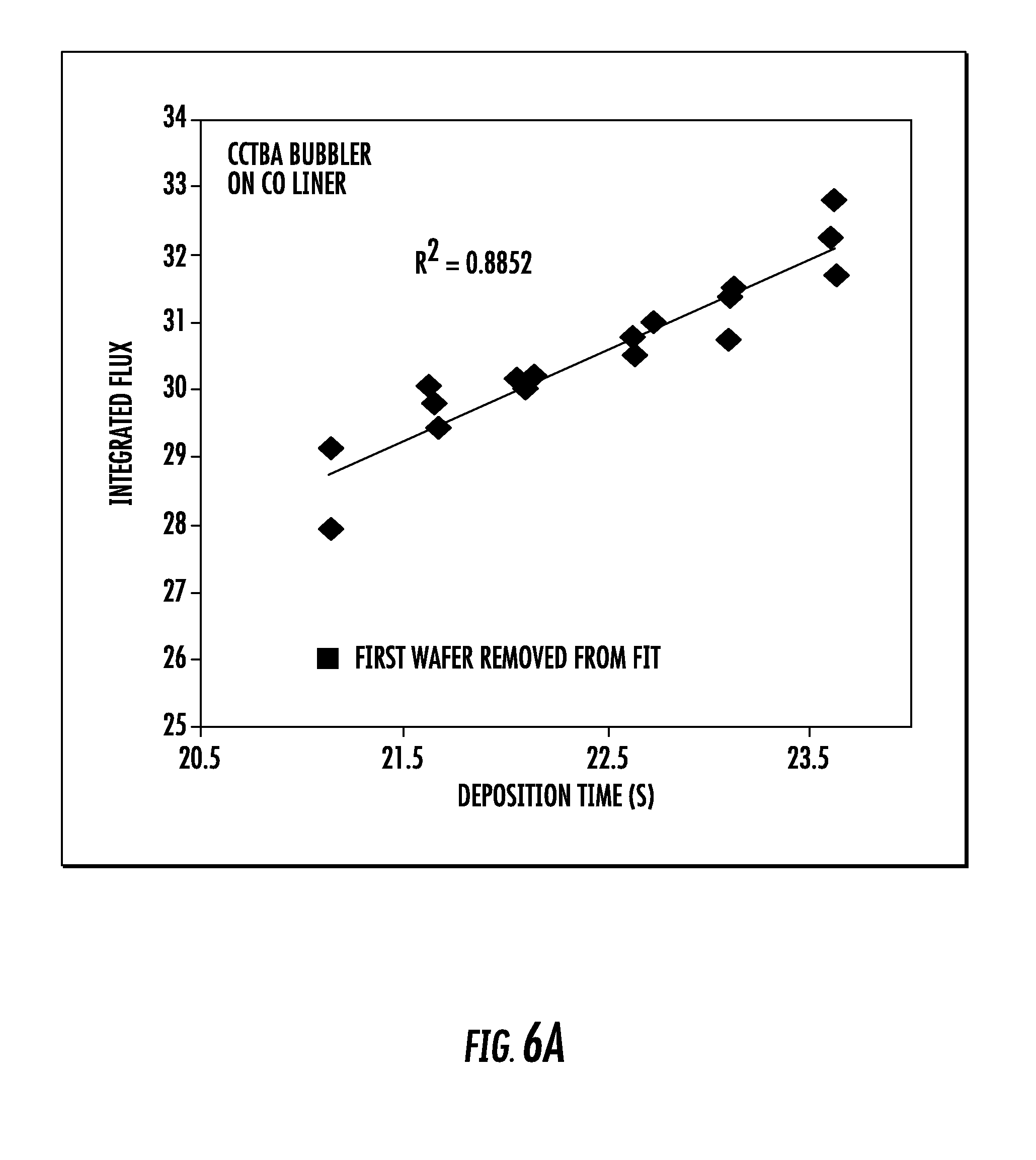



Techniques For Controlling Precursors In Chemical Deposition Processes Babayan Elaina Et Al Varian Semiconductor Equipment Associates Inc



2



Novel Endogenous Insulin Stimulated Akt2 Protein Interaction Partners In L6 Myoblasts




Bald Engineering Born In Finland Born To Ald Precursors




Characterization Of The Co Film Deposited By Mocvd Using Dicobalt




3 3 Dimethyl 1 Butyne Dicobalt Hexacarbonyl Cctba Co2 Co 6 Hc C C Ch3 3 Ereztech




Woa1 Cobalt Cvd Google Patents



2



2



Patentimages Storage Googleapis Com



Deposition Materials



2




Brent Sperling Senior Research Scientist Emd Electronics Linkedin




Msp S Liquid Source Vaporization Solutions Youtube




Major Protein Alterations In Spermatozoa From Infertile Men With Unilateral Varicocele Reproductive Biology And Endocrinology Full Text



2



Cvd Ald Precursors Semiconductor Materials Display Materials Fine Chemical Company Dnf




Protein Protein Interaction Network Organization Of The Hypusine Modification System Molecular Cellular Proteomics




Nanmat Technology Co Ltd Cvd Ald Chemical Vapr Deposition Atomic Layr Depostion
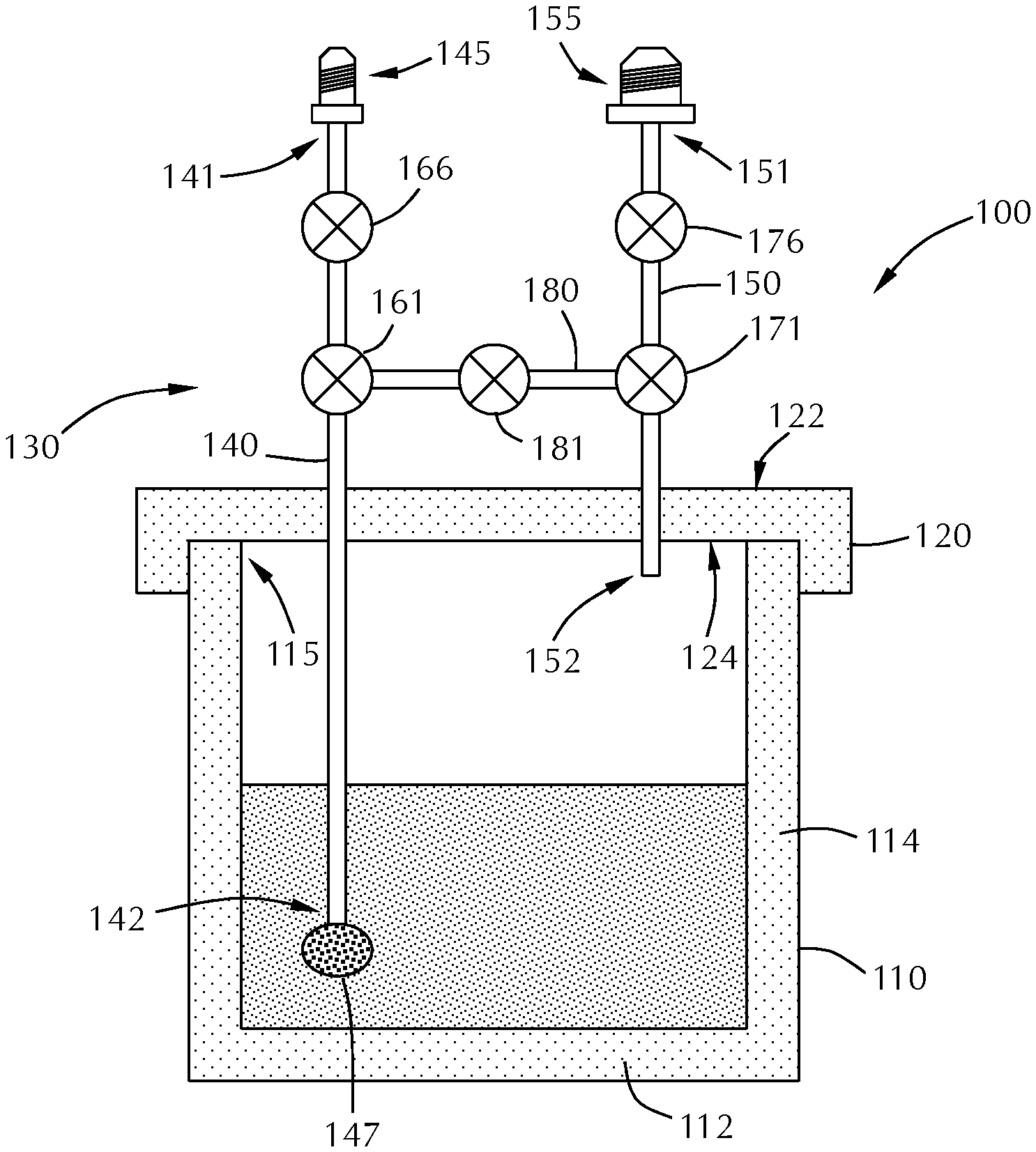



Apparatus And Methods To Remove Residual Precursor Inside Gas Lines Post Deposition Patent Grant Yao Et Al A Applied Materials Inc




Atomic Layer Deposition Of Cobalt Oxide Thin Films Using Cyclopentadienylcobalt Dicarbonyl And Ozone At Low Temperatures Journal Of Vacuum Science Technology A Vol 31 No 1




コンプリート Cctba Mtbe Decomposition



2



2



2



2



Up Chemical Co Ltd



2




Bald Engineering Born In Finland Born To Ald Umicore S Pioneering Approach To Ethical Cobalt Sourcing For Cvd Ald Precursors
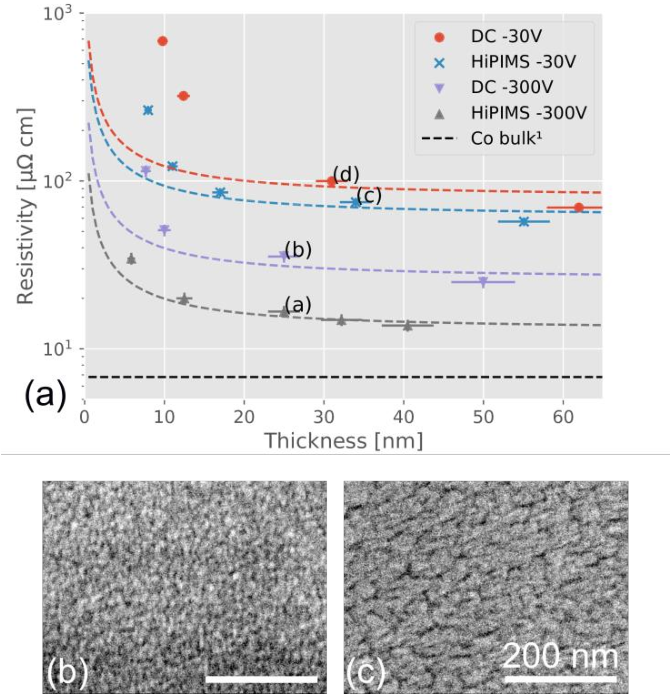



Pdf Highly Conductive Ultrathin Co Films By High Power Impulse Magnetron Sputtering Semantic Scholar



2



2



2




Pdf A Cobalt Layer Deposition Study Dicobaltatetrahedranes As Convenient Mocvd Precursor Systems
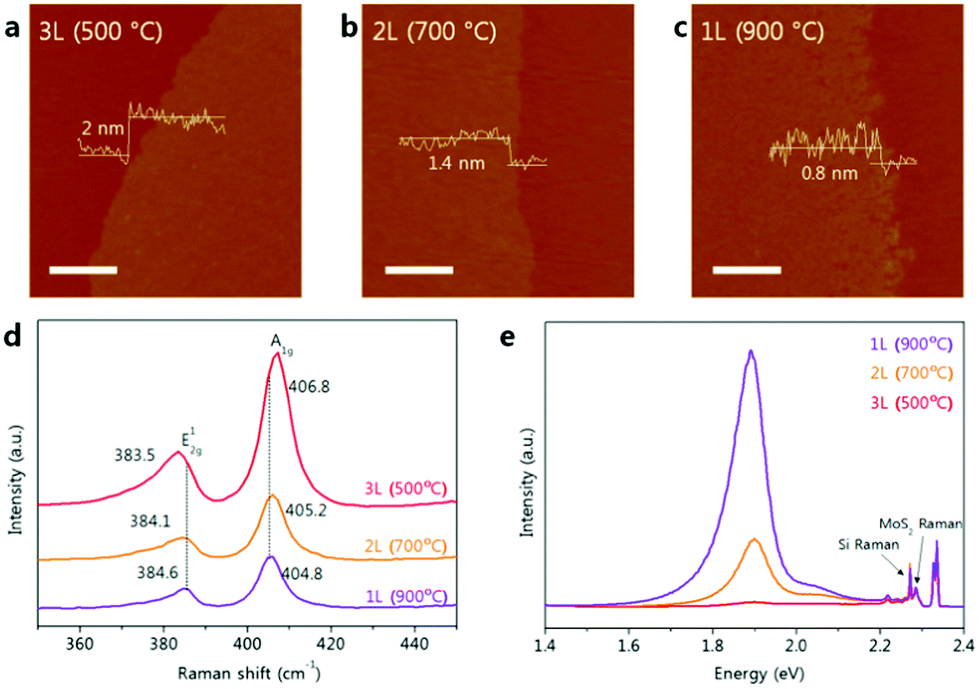



Atomic And Molecular Layer Deposition Off The Beaten Track Chemical Communications Rsc Publishing




Bald Engineering Born In Finland Born To Ald Umicore S Pioneering Approach To Ethical Cobalt Sourcing For Cvd Ald Precursors



2




Nanomaterials Free Full Text Tof Sims 3d Analysis Of Thin Films Deposited In High Aspect Ratio Structures Via Atomic Layer Deposition And Chemical Vapor Deposition Html




Dicobalt Hexacarbonyl T Butylacetylene Gelest Inc



2
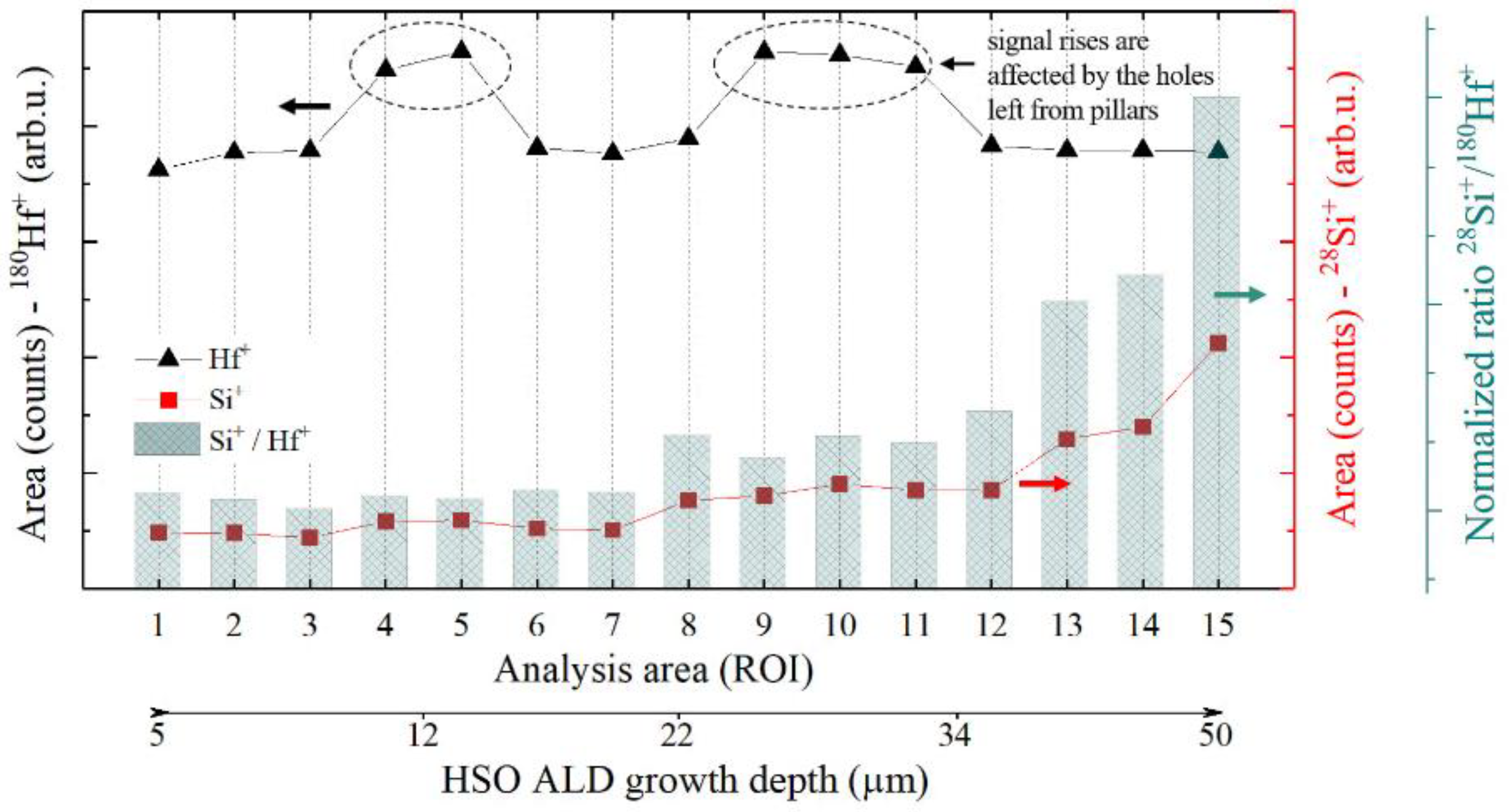



Nanomaterials Free Full Text Tof Sims 3d Analysis Of Thin Films Deposited In High Aspect Ratio Structures Via Atomic Layer Deposition And Chemical Vapor Deposition Html




Experiment Based Modelling Of A Vapor Draw Ampoule Used For Low Volatility Precursors Abstract Europe Pmc
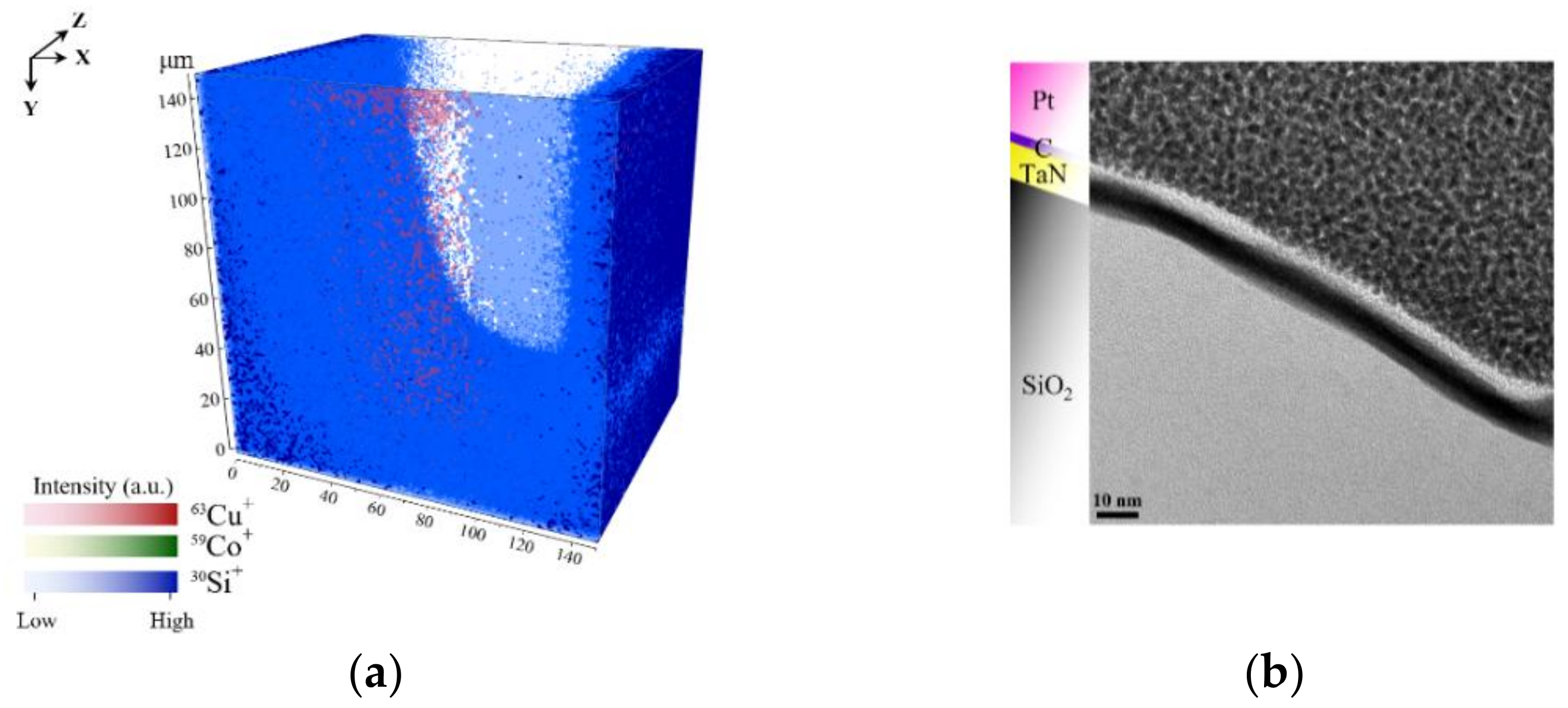



Nanomaterials Free Full Text Tof Sims 3d Analysis Of Thin Films Deposited In High Aspect Ratio Structures Via Atomic Layer Deposition And Chemical Vapor Deposition Html



2




3 3 Dimethyl 1 Butyne Dicobalt Hexacarbonyl Cctba Co2 Co 6 Hc C C Ch3 3 Ereztech
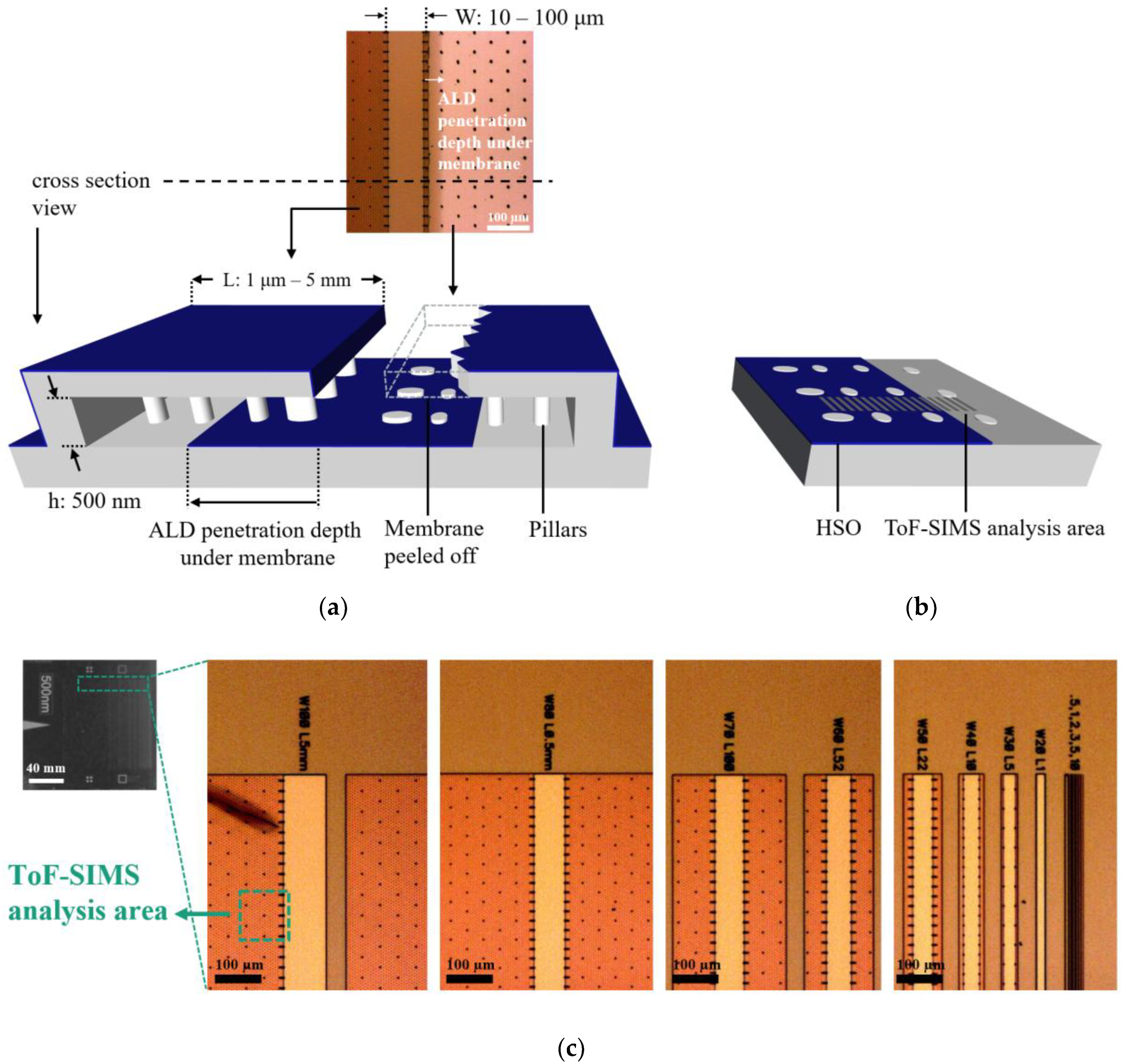



Nanomaterials Free Full Text Tof Sims 3d Analysis Of Thin Films Deposited In High Aspect Ratio Structures Via Atomic Layer Deposition And Chemical Vapor Deposition Html
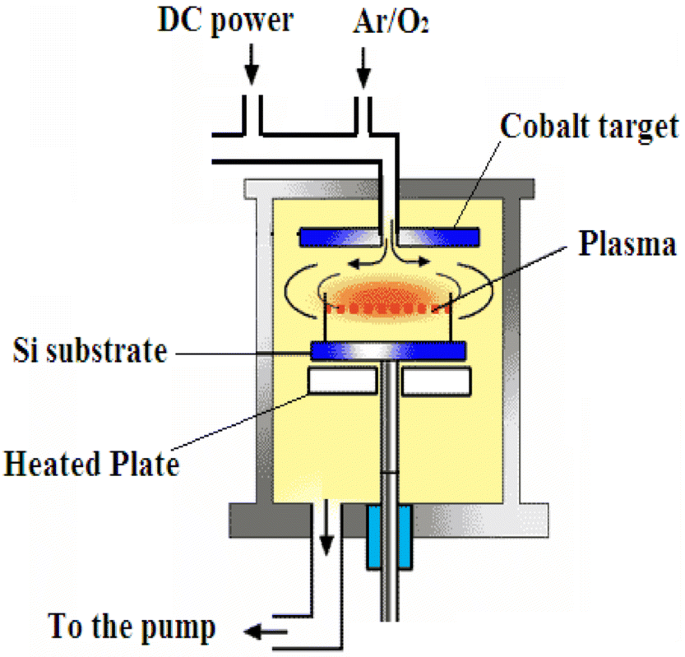



Statistical Morphological And Corrosion Behavior Of Pecvd Derived Cobalt Oxide Thin Films Springerlink



2




Bald Engineering Born In Finland Born To Ald Precursors



2



2




Calcium Hexacyanoferrate Ii Dodecahydrate




Atomic Layer Deposition Of Stoichiometric Co3o4 Films Using Bis 1 4 Di Iso Propyl 1 4 Diazabutadiene Cobalt Sciencedirect




Usa1 Disubstituted Alkyne Dicobalt Hexacarbonyl Compounds Method Of Making And Method Of Use Thereof Google Patents



2



2




3 3 Dimethyl 1 Butyne Dicobalt Hexacarbonyl American Elements



2




Leveraging Atomistic Modeling During Precursor Design For Cobalt Film Deposition Sciencedirect



2



2



Cvd Ald Precursors Semiconductor Materials Display Materials Fine Chemical Company Dnf




Temperature Of Liquid Tmga And Vapor Concentration In Response To Download Scientific Diagram




Nondispersive Infrared Gas Analyzer For Vapor Density Measurements Of A Carbonyl Containing Organometallic Cobalt Precursor Semantic Scholar




Cobalt Fab Intro Integration From Cvd To Cmp R D Accelerator Pdf Free Download




Pdf A Cobalt Layer Deposition Study Dicobaltatetrahedranes As Convenient Mocvd Precursor Systems




Usa1 Disubstituted Alkyne Dicobalt Hexacarbonyl Compounds Method Of Making And Method Of Use Thereof Google Patents




Cas 69 9 3 3 Dimethyl 1 Butyne Dicobalt Hexacarbonyl Lookchem




Cobalt Advanced Barrier Metallization A Resistivity Composition Analysis Sciencedirect



2



0 件のコメント:
コメントを投稿